アルバック・ファイ 表面分析装置の最新モデル2機種の販売を開始~多機能型XPSの基本性能を大幅向上、TOF-SIMSは全自動化により高スループットを実現
アルバック・ファイ株式会社(本社、神奈川県茅ヶ崎市、社長 原 泰博)は、X線光電子分光分析装置(XPS:X-ray Photoelectron SpectroscopyまたはESCA: Electron Spectroscopy for Chemical Analysis)および飛行時間型二次イオン質量分析装置(TOF-SIMS:Time-of-Flight Secondary Ion Mass Spectrometry)のフラッグシップモデルとなる多機能走査型X線光電子分光分析装置「PHI VersaProbe 4」と飛行時間型二次イオン質量分析装置「PHI nanoTOF 3」の2機種の販売を開始しました。
【概要】
外観デザインを全面的に刷新。白を基調とした本体にコーポレートカラーである青を直線として配したスタイリッシュな外観に加え、フルカバースタイルとすることで安全面にも配慮しました。また自動化と操作の簡便化をハードウェア・ソフトウェアの両面で実現し、遠隔操作への対応を大幅に強化しました。以下に、それぞれの装置の特長を紹介します。
多機能走査型X線光電子分光分析装置「PHI VersaProbe 4」は、日本国内のみならず、北米、EMEA、成長著しい中国市場など全世界でシリーズ累計400台の販売実績を誇る多機能型XPS装置の最新モデルです。新開発の高感度・低ノイズアナライザーにより、当社独自技術である走査型マイクロフォーカスX線源による微小高感度分析性能の向上に加え、大面積における分析性能を大幅に改善しました。大面積で当社比2倍の感度向上を実現しています。これにより分析のスループットが大幅に改善し、より短時間での分析が可能となります。さらに高感度・低ノイズアナライザーはppmオーダーの微量成分に対してもXPSならではの化学状態分析を可能とします。新機能としてSEM(Scanning Electron Microscope:走査電子顕微鏡)のように短時間で試料表面観察が可能なSXI(Scanning X-ray image)機能を広範囲に適用する「Mosaic SXI」を新たに追加。またオージェ電子分光法(Auger electron spectroscopy)の自動中和機能も追加しました。紫外光電子分光法(UPS:Ultraviolet photoelectron spectroscopy)、低エネルギー逆光電子分光法(LEIPS:Low-energy inverse photoelectron spectroscopy)、反射電子エネルギー損失分光法(REELS:Reflection electron energy loss spectroscopy)、アルゴンガスクラスタ-イオン銃(Ar-GCIB:Argon gas cluster ion beam)、試料加熱冷却機構、当社XPS、AES、TOF-SIMSの各装置間で相互利用可能な大気非暴露試料搬送機構など従来の拡張性はそのままに、半導体、二次電池、触媒など材料の研究開発から故障解析まであらゆるニーズに応えることができます。
飛行時間型二次イオン質量分析装置「PHI nanoTOF 3」は、XPSで培った全自動分析技術の全てを投入した世界初の全自動TOF-SIMS装置です。試料導入室で取得した画像を元に試料毎に分析レシピを設定することで試料搬送から測定まですべてを自動で行うことが可能で、XPS同様、材料の研究開発から、繰り返し測定を必要とする製品の品質管理まで幅広くご使用いただけます。今回の仕様変更に伴い大気非暴露試料搬送機構は当社XPS、AES装置との相互利用が可能となりました。電池材料を始め、大気下で反応性の高い材料の多角的な分析が可能となります。
TOF-SIMS測定に用いるビスマスクラスター・イオンビームの最小ビーム径を従来の70 nmから50 nmまで改善し、さらに微小部の分析が可能となりました。また、絶縁物試料に対する中和機能を大幅に改善し、あらゆる材料と分析モードで安定したTOF-SIMS分析が可能となりました。一方、測定用イオンビームによるFIB(Focused Ion Beam)加工も可能とし、FIB加工とTOF-SIMS観察を1本の同じイオン銃で実現可能となりました。凹凸試料に強いTRIFT型アナライザー、有機高分子の構造解析に欠かせないMS/MS、有機材料の深さ方向分析を可能とするAr-GCIBなどユニークな技術を搭載して、TOF-SIMSに新たな価値をお届けします。
【製品写真】

多機能走査型X線光電子分光分析装置 「PHI VersaProbe 4」
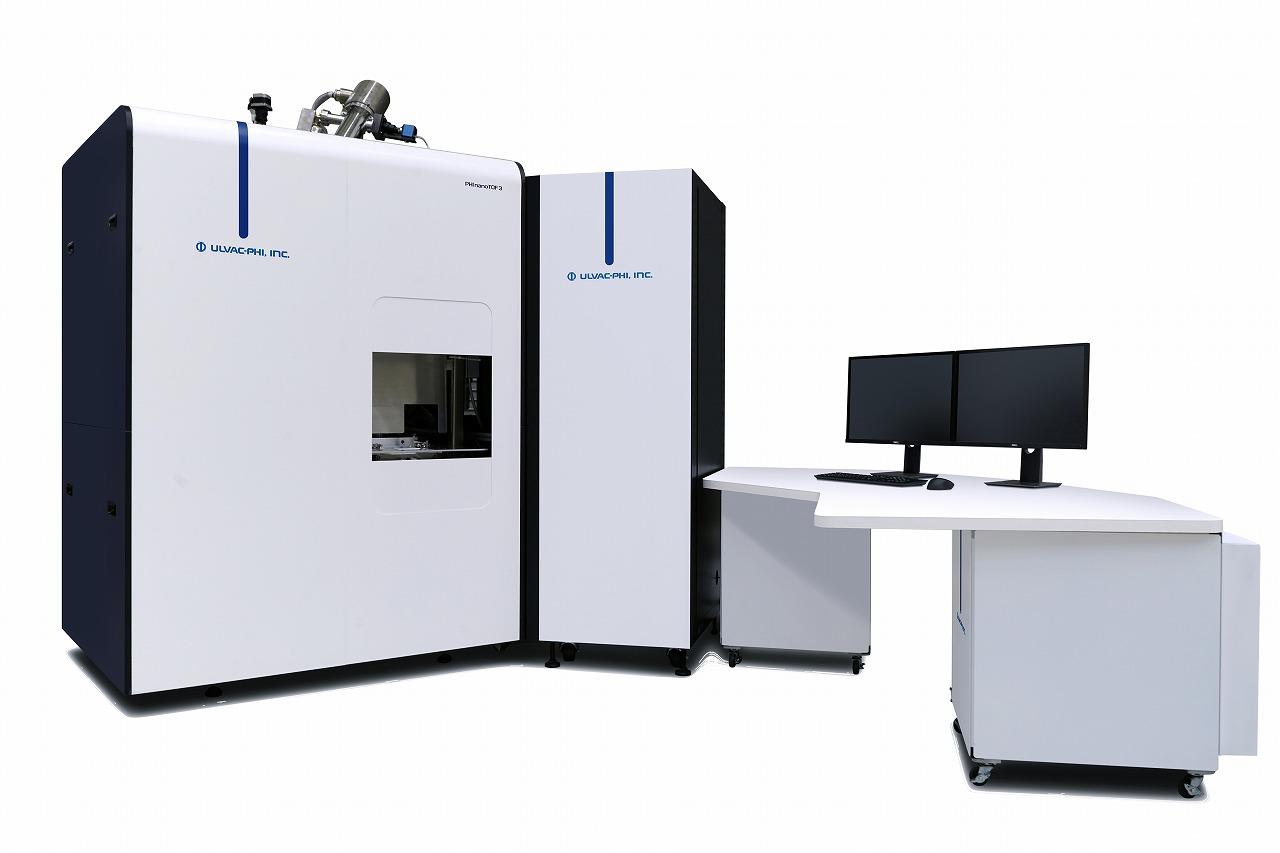
飛行時間型二次イオン質量分析装置「PHI nanoTOF 3」
【出荷開始】
2022年4月より
お問い合せ
アルバック・ファイ株式会社 製品戦略部 TEL: 0467-85-6522(代表)
株式会社アルバック web_info