This post is also available in: 英語 簡体中国語
3.ムービングカソード成膜IGZO 膜評価
3.1 膜厚面内均一性について

(a) Distribution of thickness of a film on a G6 substrate.
(b) Distribution of film thickness in transverse direction.
Figure 8 に第6 世代基板(以下,G6 基板)(1850 mm×1500 mm)に成膜したIGZO 膜厚面内分布を示した.G6 基板面内±2.9%と良好な面内均一性を示し,横方向膜厚分布では基板固定成膜にて見られたカソード起因の凹凸(Figure 2)は見られず分布±1.6%を示した.この結果,ムービングカソードでは良好な面内均一な膜厚にて成膜可能であることを実証できた.
3.2 TFT 特性について
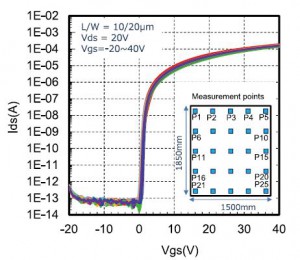
IGZO TFT with 25 points on a G6 substrate.
Figure 9 にG6 基板(1850 mm×1500 mm)基板面内25 点にて評価したIGZO TFT 初期特性評価結果を示した.ここで,Vgs はゲート-ソース間電圧,Ids はドレイン-ソース間電流である.飽和領域にて算出した移動度(μ)は基板面内平均7.5 cm2/V・sec,S 値(Sub-thresholdswing)=0.32 V/dec を示した.またVon (Ids=9nA でのVgs値)は1.1±0.25 V を示しており,TFT 初期特性においてて基板面内にて良好且つ均一な結果が得られた.次にIGZO 膜の信頼性評価を同基板面内17 点にて実施した.結果をFigure 10 に示した.ここで,Vds はソース-ドレイン間電圧であり,ストレス条件PBTS(Positive Bias Temperature Stress) はVgs=+30 V,Vds=0 V,Vds=0V,基板温度60℃にて保持,NBITS(Negative Bias Illumination Temperature Stress) はVgs=-30 V,Vds=
0 V,基板温度60℃,4500 cd/m2 の白色LED にて照射しながら保持した.各ストレス60 min 後のVon シフト量はPBTS にて0.24~0.98 V,NBITS にて-1.30~-0.5 Vを示した.この結果信頼性においても,Von シフト量が小さく,面内均一な結果を実証できた.これらの結果よりムービングカソードにて成膜したIGZO 膜は良好な面内均一性と高信頼性の膜を有することを実証できた.
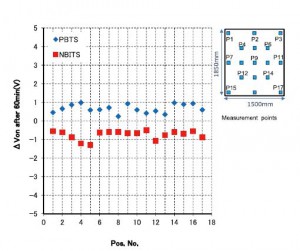
4.まとめ
大型基板での良好な面内均一性・高信頼性を有する膜の成膜を目的に,新型カソード『ムービングカソード』を開発した.本カソードでIGZO を成膜した場合,G6基板(1850 mm×1500 mm)面内にて,膜厚分布±2.9%,TFT 特性にて,移動度:7.5 cm2/V・sec,S 値:0.32 V/dec,Von=1.1±0.25 V を示した.また信頼性評価ではPBTS,NBITS ともに面内均一,高信頼性を示した.この結果,ムービングカソードにて成膜したIGZO 膜は良好な面内均一性と高信頼性の膜を有することを実証できた.
※この記事は、2015年6月発行のテクニカルジャーナルに掲載されたもので、内容は取材時のものです。
文 献
1) K. Nomura, et al.: Science 23 May 2003 Vol. 300 no.5623, 1269-1272.
2) K. Nomura, et al.: Nature 432(2004), 488.
3) K. Nomura, A. Takagi, T. Kamiya, H. Ohta, M.Hirano, and H. Hosono: Jpn. J. Appl. Phys., 45(2006),4303
4) JST News, Apri(l 2010), 6.
5) H. D. Kim, J. K. Jeong, H. J. Chung, and Y. G. Mo.:SID2008, 291.
6) K. S. Son, T. S. Kim, J. S. Jung, M. K. Ryu, et al.:SID2008, 633.
7) 坂本純一,他:応用物理学会,2013 秋季第74 回学術講演会,17-B4-14
8) Y. Kono, H. Shoji, and M. Takahashi J. Magn. Soc.Jpn. 23(1999), 1185-1188.
9) S. Takasawa, S. Ukishima, N. Tani, and S. Ishibashi. J.Vac. Soc. Jpn(2006), Vol.49 No.12), 767.
10) N. Kikuchi, and E. Kusano, J. Vac. Soc. Jpn Vol.50 No.1(2007), 15.
大久保裕夫*1・磯部辰徳*1・新井真*1・清田淳也*1・斎藤一也*1・大野哲宏*2・大空弘樹*2・佐藤重光*2
Deposition Technique of IGZO Film for Large Sputtering Cathode
Yasuo OOKUBO, Tastunori ISOBE, Makoto ARAI, Junya KIYOTA, Kazuya SAITOU, Tesuhiro OONO,
Hiroki OOZORA and Shigemitsu SAITOU
*1 Institute for Super Materials, ULVAC, Inc., 10-2, Misawa, Tomisato, Chiba, 286-0225, Japan
*2 FPD・PV Division, ULVAC, Inc., 2500 Hagisono, Chigasaki, Kanagawa, 253-8543, Japan
We developed new cathode “Moving Cathode” in order to accomplish high uniformity and high bias stability sputtering onto a large scale substrate. As a result of sputtering amorphous Indium-gallium-zinc oxide (a-IGZO) using this cathode, there indicated the film thickness distribution of ±2.9% on Generation6 substrate (1850 mm×1500 mm) and mobility: 7.5 cm2/V/sec, Sub-threshold swing: 0.32 V/dec, Von=1.1±0.25 V at TFT characteristics. Also in bias stability both positive bias temperature stress and negative bias illumination temperature stress, it demonstrated high uniformity and high bias stability.
