This post is also available in: 日语 英语
提供与作为下部电极的Pt具有高选择性的Pt/PZT刻蚀工艺。(选择比例:PZT/Pt>5@8inch, >10@6inch)
此外还提供最小化下部电极刻蚀量的高均匀性(<+/-3%@8inch)和精密的End point检测。
Challenge
・PR侧壁PZT附着
由于是难刻蚀材料,刻蚀产物容易附着在侧壁上
・与下部电极的选择比
该膜由数μm的PZT膜和约100nm的金属电极构成,使得留下下部电极的8英寸工艺变得困难
・稳定生产
由于 EPD 信号下降等原因,难以稳定生产
解决方案
・使用PZT多层膜专用等离子体源
实现刻蚀分布3%以下。实现Pt/PZT的选择比>5@8inch晶圆(>10@6inch晶圆)
・通过高均匀性和精密的终点检测,使各刻蚀膜下部的层的刻蚀量最小化
・可以在不降低EPD信号和刻蚀速率的硬件上稳定生产
可稳定生产6~8英寸
Etching Profile Uniformity of Pt/PZT Film @ 8inch
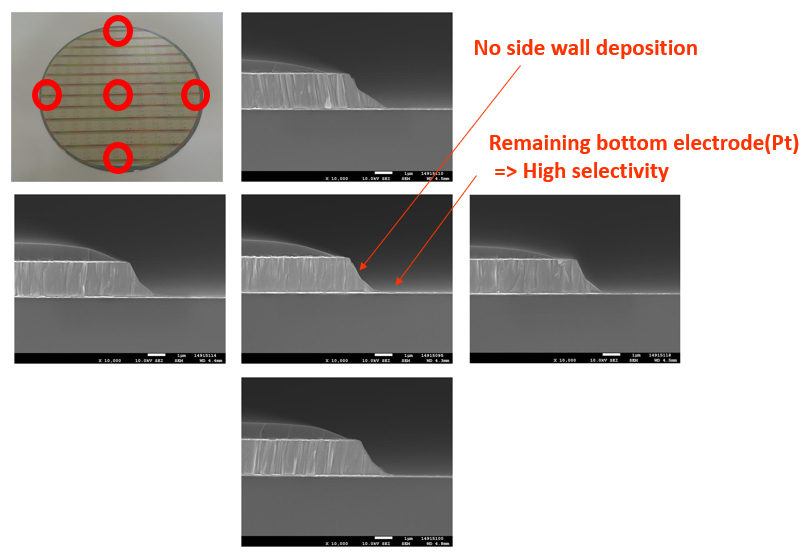 |
针对8英寸,稳定地提供保留下部Pt的工艺
Material : Pt/PZT/Pt Mask : Photo Resist Size : Depth 100/3000/100nm ER : Pt > 200nm/min PZT > 150nm/min Selectivity : Resist/PZT > 0.6 PZT/Pt > 5.0 |


