1.はじめに
飛行時間型二次イオン質量分析法(Time-of-FlightSecondary Ion Mass Spectrometry, TOF-SIMS) は, 最表面の分子種の情報を高感度かつ,高空間分解能で分析できる手法で,ゴム,プラスチック,繊維,薬剤,生体試料など,様々な有機材料表面の化学構造解析に広く用いられている.特に近年の,高質量分子イオンを高感度で分析可能なAu やBi 等のクラスターイオン源の実用化と,分子構造にほとんど損傷を与えることなく表面をスパッタ可能なC60 やAr ガスクラスターイオンの実用化1-3)により,TOF-SIMS は最表面の分析だけでなく,深さ方向分析が一般化され,3 次元解析にも応用されるようになってきた4-6).現在,TOF-SIMS は有機材料の解析に不可欠な分析手法であると言える.
このようにTOF-SIMS では,急速な応用範囲の拡大により,扱う材料の種類が急激に増え,また,着目する分子イオンも高質量になってきた.しかしながら,市販のTOF-SIMS装置では,質量がm/z 200 を超える未知の分子イオンピークを同定する場合,そのピークの構成元素が分かっていたとしても,非常に多くの組み合わせが存在するため,計測された質量値から一意的に化学式を決定することは難しい.スペクトルを理解し,表面に存在する成分を特定するためには,出現ピークの同定は必須で,難解なスペクトル解析はこれまで大きな問題となっていた7).そこで我々は,汎用のTOF-SIMS 装置にタンデム質量分析(MS/MS)を搭載し8),MS/MS による有機材料表面の化学構造解析を試みた9,10).本稿では装置の概要と特徴について述べた後,実際に従来の装置では困難であったピーク同定が,MS/MS により可能となった実例を紹介する.
(※この記事は、2017年9月発行のテクニカルジャーナルMo.81に掲載されたもので、内容は取材時のものです。)
2.「 パラレルイメージング MS/MS」を搭載したTOF-SIMS 装置
2.1 困難なTOF-SIMS スペクトル解析
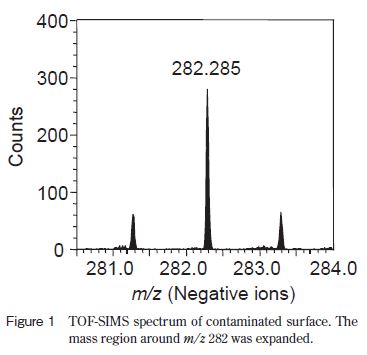
TOF-SIMS におけるピーク同定が困難な典型例を示す.Figure 1 は,汚染されたフィルム表面の負イオンスペクトルで,m/z 282 付近を拡大したものである.m/z282 を中心としてピークが検出され,清浄なフィルムからはこのピークは検出されなかった.ピークの精密質量値を読み取ると282.285 であった.汚染の由来を特定するために,ピークの同定を行った.Table 1 は,ピークの構成元素を水素,炭素,窒素,酸素であると仮定したときの化学式の候補を計測値から近い順に列記したものである.しかしながら,測定者はこの中からどれを選択すべきか見当がつかない.さらに,水素,炭素,窒素,酸素以外の元素を考慮に入れるべきかどうかも不明である.このように,一意的に決定できない不確かなピーク同定はTOF-SIMS の弱点であり,現状を打破する新たな手法が期待されてきた.
2.2 パラレルイメージングMS/MS の概要
まず,従来のTOF-SIMS 装置(PHI nanoTOF II)の概略図をFigure 2(a)に示す.パルス化した一次イオンを試料表面に照射すると,試料表面から 二次イオンが放出される.この二次イオンを引き込み電極によりアナライザに導入し,二次イオンが検出器に到達するまでの質量の違いにより生じる飛行時間差を利用して質量分離を行い,質量スペクトルを得る.試料から放出された二次イオンはエネルギー分布や角度分布を持つため,同じ質
二次イオンが放出される.この二次イオンを引き込み電極によりアナライザに導入し,二次イオンが検出器に到達するまでの質量の違いにより生じる飛行時間差を利用して質量分離を行い,質量スペクトルを得る.試料から放出された二次イオンはエネルギー分布や角度分布を持つため,同じ質
量でも飛行時間差が生じるが,図に示す3 つの静電アナライザ(ES1, ES2, ES3)は,エネルギー分布や角度分布の違いによって発生する飛行時間差を相殺する働きを持つ11).一次イオンのパルスとパルスの間隔は,取得する質量スペクトルの質量範囲によって決まり,TOFSIMSで一般的なm/z 0 から2000 までの質量の二次イオンを取り込む条件では,パルス間隔は約125 μs(パルス周波数は約8000 Hz)となる.スペクトルの質量分解能(M/ΔM)は,主に一次イオンのパルス幅と,二次イオンの飛行時間に依存し,汎用のTOF-SIMS 装置では10000 程度の値が得られる.
また,一次イオン銃には,容易に100 nm 以下のビーム径が実現できる液体金属型イオン銃が広く用いられる.細く絞ったイオンビームを試料上で走査させることで,各位置に対応するスペクトル情報が記録さ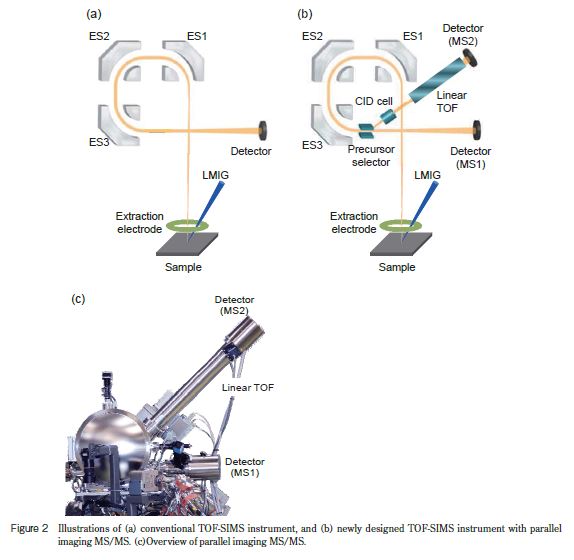 れ,高精細なイメージングを可能とする.以上が,従来のTOF-SIMS 装置の概要である.次に,パラレルイメージングMS/MS を搭載したTOF-SIMS 装置の概略図をFigure 2(b)に,外観写真をFigure 2(c)に示す.従来の装置に,プリカーサーセレクター,衝突誘起解離用の衝突セル(CID Cell)及び,直線型TOF を組み込んだ.プリカーサーセレクターでは,指定の質量の二次イオンのみ軌道が曲げられ,それ以外の二次イオンは直進する.軌道を曲げられたイオンは約1.5 keV のエネルギーで衝突セルに導入される.セル内にはAr ガスが封入されており,この中を通過するイオンが,ガス分子との衝突により解離する.解離したフラグメントイオンの質量は,直線型TOF により計測される.本装置では2 つの質量分析計(MS1 及びMS2)を有し,それぞれの分析計で得られるスペクトルをMS1スペクトル,MS2 スペクトルと区別する.一般的なMS/MS 装置では,MS1 スペクトルとMS2 スペクトルの同時取得はできないが,本装置は,MS1,MS2 両スペクトルの同時取得が可能なパラレル型を採用している.さらに,MS2 スペクトル取得時のパルス周波数は従来のTOF-SIMS 装置と同じであり( パルス周波数: 約8000 Hz),従来同様の高速な測定が可能である.
れ,高精細なイメージングを可能とする.以上が,従来のTOF-SIMS 装置の概要である.次に,パラレルイメージングMS/MS を搭載したTOF-SIMS 装置の概略図をFigure 2(b)に,外観写真をFigure 2(c)に示す.従来の装置に,プリカーサーセレクター,衝突誘起解離用の衝突セル(CID Cell)及び,直線型TOF を組み込んだ.プリカーサーセレクターでは,指定の質量の二次イオンのみ軌道が曲げられ,それ以外の二次イオンは直進する.軌道を曲げられたイオンは約1.5 keV のエネルギーで衝突セルに導入される.セル内にはAr ガスが封入されており,この中を通過するイオンが,ガス分子との衝突により解離する.解離したフラグメントイオンの質量は,直線型TOF により計測される.本装置では2 つの質量分析計(MS1 及びMS2)を有し,それぞれの分析計で得られるスペクトルをMS1スペクトル,MS2 スペクトルと区別する.一般的なMS/MS 装置では,MS1 スペクトルとMS2 スペクトルの同時取得はできないが,本装置は,MS1,MS2 両スペクトルの同時取得が可能なパラレル型を採用している.さらに,MS2 スペクトル取得時のパルス周波数は従来のTOF-SIMS 装置と同じであり( パルス周波数: 約8000 Hz),従来同様の高速な測定が可能である.
TOF-SIMSに関して詳しく知りたい方はこちら
https://www.ulvac-phi.com/ja/surface-analysis/tof-sims/
記事の続きは下記URLよりアルバックテクニカルジャーナルにユーザ登録するとご覧いただけます。
https://www.ulvac.co.jp/r_d/technical_journal/user_registration/
文 献
1) N. Sanada, A. Yamamoto, R. Oiwa and Y. Ohashi:Surf. Interface Anal., 36(2004)280.
2) S. Ninomiya, K. Ichiki, H. Yamada, Y. Nakata, T. Seki,T. Aoki and J. Matsuo: Rapid Commun. MassSpectrom., 23(2009)1601.
3) T. Miyayama, N. Sanada, S. R. Bryan, J. S. Hammondand M. Suzuki: Surf. Interface Anal., 42(2010)1453.
4) J. S. Fletcher, N. P. Lockyer, S. Vaidyanathan and J. C.Vickerman: Anal. Chem., 79(2007)2199.
5) G. L. Fisher, A. M. Belu, C. M. Mahoney, K. Wormuthand N. Sanada: Anal. Chem., 81(2009)9930.
6) S. Iida: KENBIKYO 48(2013)159.
7) S. Otomo, H. Itoh and Y. Abe: 18th InternationalConference on Secondary Ion Mass Spectrometry,(2011)p. 280.
8) P. E. Larsen, J. S. Hammond, R. M. A. Heeren and G.L. Fisher: U.S. Patent 20150090874(2015).
9) G. L. Fisher, A. L. Bruinen, N. Ogrinc Potočnik, J. S.Hammond, S. R. Bryan, P. E. Larson and R. M. A.Heeren: Anal. Chem., 88(2016)6433.
10) S. Iida, G. L. Fisher, J. S. Hammond, S. R. Bryan and T.Miyayama: J. Surf. Sci. Soc. Jpn., 37(2016)354.
11) B. W. Schueler: Microsc, Microanal. Microstruct., 3(1992)119.
12) NIST MS Search Program(Version 2.2)

